
ICP Etcher Bosch Deep Reactive
Ion Etcher
φ330mm 양산용 Tray, Cassette 식 LED 제조 System
[Specification]
| System | RIE-330lpc |
|---|---|
| Chamber type | LL, CC |
| Sample Stage | AI, φ330mm |
| Effective diameter | φ330mm |
| RF power | Max. 1Kw / 1kw |
| Dimensions (W/D/H)mm | 1470 / 2600 / 2320 |
* LL : Loadlock chamber
CC : Cassette chamber
[Applications]
- GaN electronic devices
- Light emitting devices
[Features]
- φ2” x27, φ3” x12, φ4” x7, φ6” x3 wafers 동시 처리가능
- SSTL(Symmetrically Shielded Tornado Coil) System
높은 선택비, 고정밀 및 균일성이 우수함 - 낮은 Bias(-100v 이하) 최소한의 데미지 프로세스 가능

Bosch Deep Reactive Ion Etcher
Bosch Process를 이용한 고속 Silicon Deep Etching System
[Specification]
| System | RIE-800lpb |
|---|---|
| Chamber type | LL |
| Sample Stage | AI, φ208mm |
| Effective diameter | φ6inch (φ8inch) |
| RF power | Max. 3kw / 500w |
| Dimensions (W/D/H)mm | 1000 / 1826 / 1850 |
* LL : Loadlock chamber
CC : Cassette chamber
[Applications]
- Inkjet 프린터 헤드의 제조
- Via hole 형성을 통한 3D packaging application
- medical devices, MEMS
[Features]
- 독특한 Plasma Source 및 Chamber 구조로
고속 Si Etching 가능

Reactive Ion Etcher
Si, Poly-Si, SiO2, Si3N4 등 각종 실리콘 박막을 Etching 하는 System
[Specification]
| System | RIE-800lpb |
|---|---|
| Chamber type | - |
| Sample Stage | SUS, φ390mm |
| Effective diameter | φ350mm |
| RF power | Max. 1kw |
| Dimensions (W/D/H)mm | 850 / 2024 / 1912 |
* LL : Loadlock chamber
CC : Cassette chamber
[Applications]
- Failure analysis
[Features]
- Large diameter sample stage (φ390mm)
- 3” x12, 4” x8, 6” x3 Wafer 동시 처리 가능
(Max. size 12inch 가능) - 4방향 고속배기 시스템

ICP Etcher System RIE-800IPC
공정 재현성이 뛰어난 생산용 장치
[Specification]
| System | RIE-800lpb |
|---|---|
| Chamber type | Cassette to Cassette |
| Sample Stage | AI, φ432mm |
| Effective diameter | φ6” Samco made cassette |
| RF power | Max. 3kw / 1kw |
| Dimensions (W/D/H)mm | 1100 / 2200 / 2250 |
* LL : Loadlock chamber
CC : Cassette chamber
[Applications]
- GaN, GaAs, InP 등의 화합물 반도체의 고정밀 가공
- SiC, SiO₂의 고속 가공
- 강유전체(PZT, BST, SBT, BT)나 전극재료(pt, Au, Ru, AI)등 논에칭 재료의 에칭
- 화합물 반도체 웨이퍼의 플라즈마 다이싱
[Features]
- 신형 ICP 소스 (HSTC : Hyper Symmetrical Tornado Coil)
- 대량 배기 시스템
- 하부 전극 상강 시스템
- 유지 보수 쉬운 설계

ICP Etcher System RIE-200IPN
차세대 프로세스 개발용
[Specification]
| System | RIE-800lpb |
|---|---|
| Chamber type | LL |
| Sample Stage | AI, φ380mm |
| Effective diameter | φ6” , φ8” |
| RF power | Max. 1kw / 300w, 500kw |
| Dimensions (W/D/H)mm | 950 / 1375 / 1735 |
* LL : Loadlock chamber
CC : Cassette chamber
[Applications]
- GaN, GaAs, InP 등의 화합물 반도체의 고정밀 가공
- 강유전체(PZT, BST, SBT, BT)나 전극재료(pt, Au, Ru, AI) 등 논에칭 재료의 에칭
[Features]
- 신형 ICP 소스 (HSTC : Hyper Symmerical Tornado Coil)
- 차세대 프로세스 개발
- 유지 보수 쉬운 설계

Liquid Source CVD Plasma CVD
고품질의 두꺼운 Silicon oxide film 형성 System
[Specification]
| System | PD-330STC |
|---|---|
| Chamber type | LL, CC |
| Sample Stage | SUS, φ360mm |
| Effective diameter | φ12inch |
| RF power | Max, 1.5.kw |
| Dimensions (W/D/H)mm | 2393 / 3595 / 2011 |
* LL : Loadlock chamber
CC : Cassette chamber
[Applications]
- optical waveguide의 제조
- MEMS에 Etching Mask 희생 산화막 형성
- nsulation film on sidewalls of via holes for 3D package
[Features]
- SAMCO의 독자적인 자기 Bias 증착 방법
- high speed deposition
- Low temperature deposition (less than 80°C)

Plasma CVD
compound semiconductor device의 passivation 층
형성 System
[Specification]
| System | PD-220LC |
|---|---|
| Chamber type | LL |
| Sample Stage | SUS, φ260mm |
| Effective diameter | φ220mm |
| RF power | Max, 300w |
| Dimensions (W/D/H)mm | 1200 / 2100 / 2065 |
* LL : Loadlock chamber
CC : Cassette chamber
[Applications]
- 각종 실리콘계 박막형성 가능 (Si3N4, SiO2 등)
[Features]
- 화합물 반도체 프로세스에서 passivation이나 층간 절연막 등 step-coverage가 뛰어난 막 형성 가능

ALD (Atomic Layer Deposition)
유기금속 원료와 산화제를 번갈아 공급, 표면 반응만을 이용 성막 시스템
[Introduction]]
- ALD-800LP는 원자 레벨의 막 두께 제어가 가능한 ALD (Atomic Layer Deposition : 원자층 퇴적) 장치.
- 유기 금속원료 및 산화제를 번갈아 반응실에 공급하고 표면 반응만으로 성막 재현성이 우수한 성막이 가능
[Applications]
- 질화막(AIN, SIN)의 성막, 산화막(AIOx, SiO₂)의 저온 성막
- 전자 장치의 게이트 절연막
- 반도체•유기 EL등의 패시베이션막
- 반도체 레이저의 반사면
- MEMS 등 3차원 구조의 성막
- 그래핀 성막
- 탄소나노튜브 보호막 분체 코팅
[Features]
- 원자 한층 레벨의 균일한 레이어 컨트롤 가능
- 높은 종횡비 구조에 대한 등각성막이 가능
- 면내 균일성과 재현성이 뛰어나 안정된 프로세스 실현
- 원료의 가스라인, 가스 흐름을 최적화한 독자적인 반응실 구조로 파티클 억제
- 용량 결합플라즈마(CCP) 방식을 채택함으로써 반응실 용적을 최소화
- 가스의 퍼지 시간을 단축하고 1사이클을 고속화

UV-Ozone cleaner (R&D)
반도체 공정의 완전건조 처리를 고농도 오존 및 자외선 조사하는 System
[Specification]
| System | UV-1 |
|---|---|
| Sample Stage | AI, φ200mm |
| UV lamps | 110w x 1 |
| Ozone killer | Common metal honeycomb catalyst |
| Dimensions (W/D/H)mm | 450 / 400 / 411 |
[Applications]
- Photo register, 실리콘 Wafer, 크리스탈 액정, 렌즈,
Cr Mask ITO 전극 표면 Cleaning, 화합물 반도체,
각종 기타 유기물 제거 및 표면 개질에 사용
[Features]
- 대기압 동작으로 진공 System이 불필요
- Compact한 디자인으로 조작과 유지 관리가 용이

UV-Ozone cleaner
(Cassette Version)
반도체 공정의 완전건조 처리를 고농도 오존 및
자외선 조사하는 System
[Specification]
| System | UV-300HC |
|---|---|
| Sample Stage | AI, φ280mm |
| UV lamps | 235w x 1 |
| Ozone killer | Common metal honeycomb catalyst |
| Dimensions (W/D/H)mm | 1100 / 1740 / 1625 |
[Applications]
- Photo register, 고속 스트립 (200~300nm/min)
- ITO 전극 표면 Cleaning
- 실리콘 Wafer, 크리스탈 액정, 렌즈, Cr Mask 각종 기타 유기물 제거 및 표면 개질에 사용
[Features]
- 대기압 동작으로 진공 System이 불필요
- 용도에 따라 UV 모드, Ozone 모드, UV+Ozone 모드 선택가능
- Photo register 경화 (Ozone 미사용 시)
- 6, 8inch 카세트 처리 가능
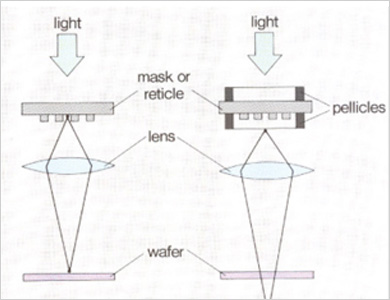
PELLICLE USAGE
Matsushita Seiki
Matsushita Seiki – Pellicle Mounter (Auto, manual) for Semiconductor and FPD
Matsushita Seiki also works with customers as a partner to provide better products through consulting and servicing activities. We offer you the results of our extensive expertise, through our latest high quality products.
반도체 / LCD 공정 중 빠질 수 없는 공정 중의 하나가 노광 공정일 것입니다. 각각의 노광기에는 패턴을 만들기 위한 필름 역할의 mask가 있는데 마스크의 보호, 파티클 유입의 방지 등을 위해 펠리클을 씌워줍니다.
이를 엔지니어가 직접 작업을 한다면 그 자체가 오염원이 되므로 저희 Pellicle Mounter로서 시스템 혹은 로봇으로 자동화 작업을 합니다.
저희 Matsushita Seiki는 섬유 산업 시대의 자동화부터 첨단 반도체 / LCD 공정의 자동화에 이르기까지 자동화 부문의 선두주자라 할 수 있으며 특히 Pellicle mounter에 있어서는 타에 추종을 불허하는 노하우를 지니고 있습니다.
EQUPMENT
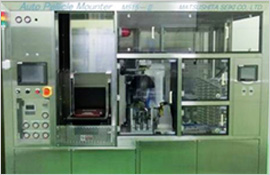
- AUTO PELLICLE MOUNTER

- MANUAL PELLICLE MOUNTER

- FPD PELLICLE MOUNTER
표준타입 낱장식 SPIN 에칭(세정)장치
카셋트 TO 카셋트 방식 또는 전, 후처리 설비와의 IN-LINE화가
가능합니다. 카셋트 방식에 비해 약액을 크게 절감할 수 있어
경제적입니다. BRUSH 방식 세정도 가능합니다.
WORK는 횡반송형과 종반송형 모두 제작 가능합니다.
EQUIPMENT
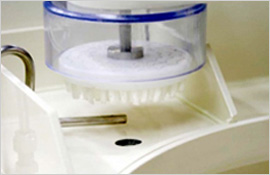
- PRODUCT DETAIL1

- PRODUCT DETAIL2

- PRODUCT DETAIL3

버티클타입 낱장식 SPIN
에칭(세정) 장치
질소압을 이용하여 WAFER의 뒷면을 액이 오염시키지 않도록
독자적인 설비를 개발하였습니다. 수직형 방식의 설계로써
기존의 수평형 설비에 비해 설비 설치 면적을 적게 차지합니다.
독차적인 CHUCK 개발로 SIZE가 다른 WAFER도 겸용하여
사용할 수 있도록 하였습니다.
(예)진공 + SUPPORT부착 CHUCK
01 설비의 설치면적이 작다
낱장처리로 설치면적 小
02 뒷면(액에 의한 오염 방지)
진공 CHUCK과 N2 GAS 분사 겸용
또는 N2 GAS 분사와 GUIDE PIN
03 약액
약액조가 없는 SPRAY 방식 (고압 SPRAY 가능)
약액을 순환하여 재사용 대응
온도관리, 농도관리 가능
04 건조
SPIN, N2 BLOW
처리 FLOW
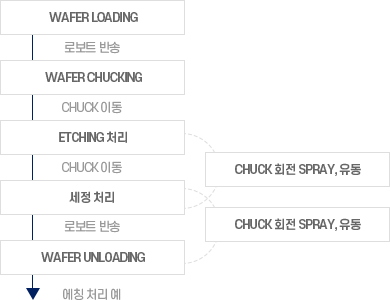
진공 + N2 BLOWER 부착 CHUCK

FULL SPEC HU형 *LINE UP

FULL SPEC HU형
[특징]
양산대응 설비 BATCH, 매엽 겸용으로 [보다 빠르고,
보다 확실한] 처리가 가능합니다. 팽윤처리 후 매엽처리에 따라
-매엽처리시간 단축
-BURR 등 불량율 저감
-확실한 마무리 처리

- JET

- 매엽

- BATCH

- FULL SPEC HU형(개략도)
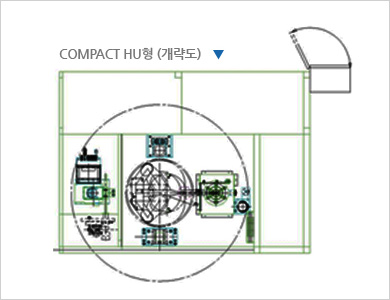
COMPACT HU형
양산, 시생산, 개발용도 용
FULL SPEC HU형의 특징을 살린 COMPACT형
기능을 압축하여 다운사우징 실현

- BATCH

- 매엽

- JET
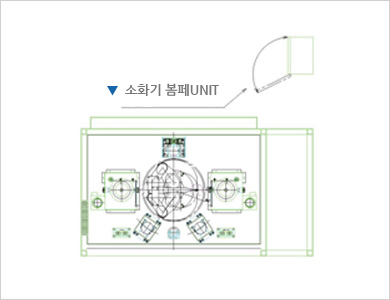
HM형
양산, 시생산, 개발용도
비교적 박리하기 쉬운 wafer
jet 처리만으로 박리가 가능한 wafer
burr가 잘 안 나오는 wafer
처리시간이 길어도 문제없는 경우
옵션으로 메가소닉 샤워, 퍼들기구 대응
MJ형
개발용도
JET CHEMBER만을 가지고 있고,
WAFER LOADING/UNLOADING은 수동
옵션 *LIFT OFF SYSTEM에는 아래 옵션 적용이 가능합니다.
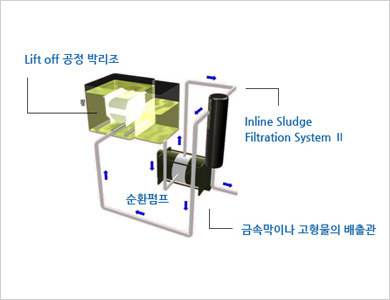
ISF SYSTEM
(Inline Sludge Filtration)
박리조에서 나오는 금속을 분리, 회수할 수 있는 system
박리 찌꺼기 포집능력 10μm〈 95% 이상(순수일 경우)
박리
찌거기의 회수가 매우 용이
ISF 사용에 따른 main filter의 수명
연장
교환 빈도의 극감, 안전과 환경(산업폐기 감소)을 배려
ISF는 Maintenance 불필요
소모품이 없고, Maintenance 불필요


SUFFIX SYSTEM
(Surface Ultra sonic Flat Fix)
박리조의 초음파 효율을 올려주는 시스템
[특징]
- BATCH 처리 초음파의 문제점을 해결
- Wafer cassette에 의한 감쇄가 거의 없음.
- Cassette내에서 wafer 회전 불필요
- 초음파 효율이 좋아짐
- 처리 시간의 대폭단축
- 상온 박리액에서도 안정적인 처리가 가능
- 위험한 약액을 사용하지 않고도 처리가 가능
[Suffix system의 효과]
4인치 웨이퍼 표면에 알루미늄 호일 11um을 붙여서,
그 표면 damage를 관찰
[Test조건]
처리액 : 순수
처리시간 : 10분
처리온도 : 26~28도
TWT SYSTEM
(Thin Wafer Transfer)
얇게 휘어진 wafer를 반송, lift off하는 system

- 반송 test 장치

- 반송 Arm
[특징]
[얇게 휘어진 wafer]에 적용 가능한 반송 system
TWT system과 lift off 시스템의 결합
휘어진 wafer도 lift off 처리가 확실하게 됨.
MT SYSTEM (Mist Trap)
배기되는 약액 mist를 억제하고, 배기 duct를 보호

[특징]
배기배관 duct 내에서의 액화를 억제
장치에서 나오는 약액 mist가 혼입한 배기 gas에 작용
장치 배기구에 붙여, 냉각수에 의한 냉각으로 효력 발휘
액화되어버리는 장소에 따라 낮은 온도의 냉각수가 best
사용약액, 장치사양이나 설치환경에 맞추어서 제작
초음파 모니터

[종래]
액중의 정재파에 따라, 깊이나 위치에서 측정치의 오차가 큽니다.
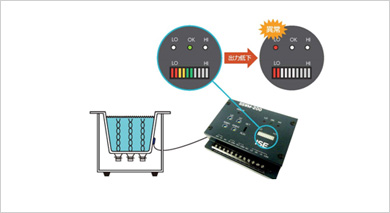
[신제안]
정점측정에 따라, 정재파의 영향을 불식.
또한 내부 알고리즘 처리에 따라 안정된 모니터링이 가능